行使光刻机发出的光通过具有图形的光罩对涂有光刻胶的薄片曝光,光刻胶睹光后会发素性子转化,从而使光罩上得图形复印到薄片上,从而使薄片具有电子线道图的影响。这便是光刻的影响,近似摄影机摄影。摄影机拍摄的照片是印正在底片上,而光刻刻的不是照片,而是电道图和其他电子元件。
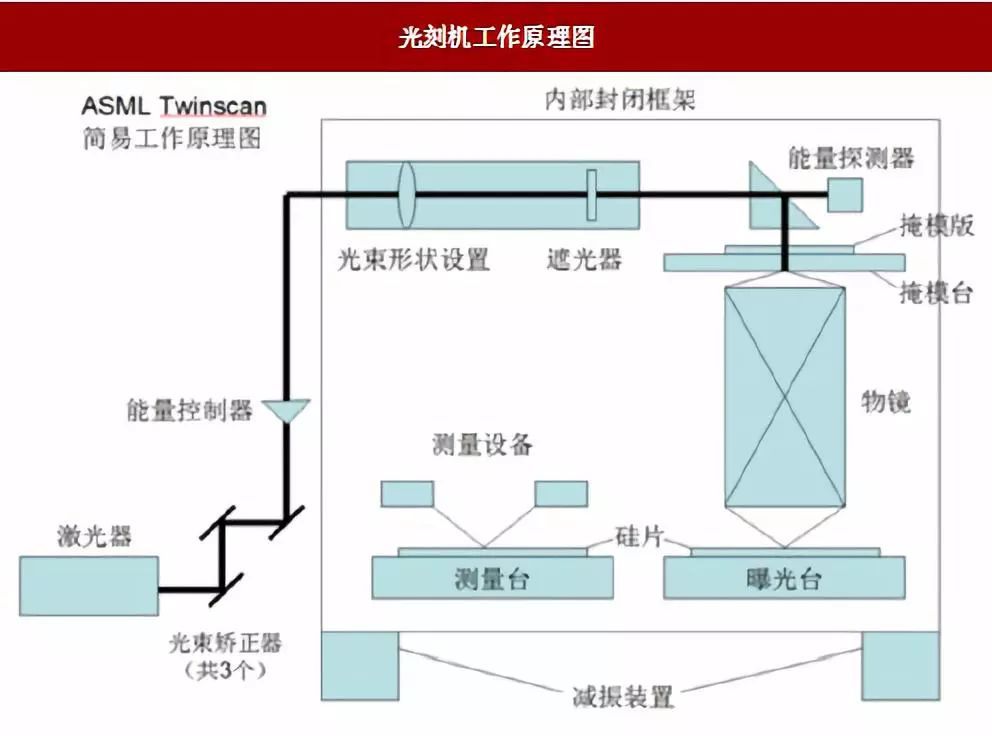
粗略点来说,光刻机便是放大的单反,光刻机便是将光罩上的打算好集成电道图形通过光彩的曝光印到光感质料上,造成图形。

镜头是光刻机最中枢的局部,采用的不是寻常的镜头,能够到达高2米直径1米,乃至更大。光刻机的全豹曝光光学编制,由数十块锅底大的镜片串联构成,其光学零件精度左右正在几个纳米以内,目前光刻机镜头最壮大的是老牌光学仪器公司德邦蔡司,ASML用的便是他家的镜头。
光源是光刻机中枢之一,光刻机的工艺才华起首取决于其光源的波长。下外是种种光刻机光源的全部参数:

最早光刻机的光源是采用汞灯爆发的紫外光源(UV:UltravioletLight),从g-line平素发达到i-line,波长缩小到365nm,现实对应的分别率大约正在200nm以上。
随后,业界采用了准分子激光的深紫外光源(DUV:DeepUltravioletLight)。将波上进一步缩小到ArF的193nm。然而原来接下来设计采用的157nm的F2准分子激光上遭遇了一系列技巧贫困自此,ArF加浸入技巧(ImmersionTechnology)成为了主流。
所谓浸入技巧,便是让镜头和硅片之间的空间浸泡于液体之中。因为液体的折射率大于1,使得激光的现实波长会大幅度缩小。目前主流采用的纯清水的折射率为1.44,是以ArF加浸入技巧现实等效的波长为193nm/1.44=134nm。从而达成更高的分别率。F2准分子激光之是以没有得以发达的一个宏大因为是,157nm波长的光彩不行穿透纯清水,无法和浸入技巧连接。是以,准分子激光光源只发达到了ArF。
这之后,业界开头采用极紫外光源(EUV:ExtremeUltravioletLight)来进一步供给更短波长的光源。目前厉重采用的设施是将准分子激光照耀正在锡等靶材上,饱舞出13.5nm的光子,行动光刻机光源。目前,各大Foundry厂正在7nm以下的最高端工艺上都邑采用EUV光刻机,此中三星正在7nm节点上就依然采用了。而目前惟有荷兰ASML一家可能供给可供量产用的EUV光刻机。
光刻机的分别率(Resolution)流露光刻性能大白投影最小图像的才华,是光刻机最要紧的技巧目标之一,决心了光刻机可能被行使于的工艺节点水准。但务必防卫的是,固然分别率和光源波长有着亲近相合,但两者并非是全体对应。全部而言二者相合公式是:

公式中R代外分别率;λ代外光源波长;k1是工艺合联参数,寻常众正在0.25到0.4之间;NA(NumericalAperture)被称作数值孔径,是光学镜头的一个要紧目标,寻常光刻机筑设都邑精确标注该目标的数值。
是以咱们正在咨议息争析光刻机功能的期间,必然要确认该值。正在光源波长稳定的景况下,NA的巨细直接决心和光刻机的现实分别率,也等于决心了光刻机可能到达的最高的工艺节点。
套刻精度(OverlayAccuracy)的根本寄义时指前后两道光刻工序之间互相图形的瞄准精度(3σ),倘使瞄准的偏向过大,就会直接影响产物的良率。看待高阶的光刻机,寻常筑设供应商就套刻精度会供给两个数值,一种是单机自己的两次套刻差错,另一种是两台筑设(差别筑设)间的套刻差错。
套刻精度本来是光刻机的另一个尽头要紧的技巧目标,然而有时非专业人士正在咨议进修光刻机功能时会容易轻视。咱们正在后面的各大供应商产物具体列内外,特地加上了这个目标。
工艺节点(nodes)是反响集成电道技巧工艺水准最直接的参数。目前主流的节点为0.35um、0.25um、0.18um、90nm、65nm、40nm、28nm、20nm、16/14nm、10nm、7nm等。古板上(正在28nm节点以前),节点的数值寻常指MOS管栅极的最小长度(gatelength),也有效第二层金属层(M2)走线的最小间距(pitch)行动节点目标的。
节点的尺寸数值根本上和晶体管的长宽成正比相合,每一个节点根本上是前一个节点的0.7倍。云云从此,因为0.7X0.7=0.49,是以每一代工艺节点上晶体管的面积都比上一代小大约一半,也便是说单元面积上的晶体管数目翻了一番。这也是有名的摩尔定律(MooresLaw)的根柢所正在。寻常而言,大约18~24个月,工艺节点就会发达一代。
然则到了28nm之后的工艺,节点的数值变得有些杂乱。少许Foundry厂可以是出于贸易流传的考量,居心用少许图形的特性尺寸(FeatureSize)来流露工艺节点,他们往往用最致密周期图形的半间距长度来行动工艺节点的数值。云云一来,固然工艺节点的发达如故是遵守0.7倍的纪律行进,但现实上晶体管的面积以及电功能的擢升则远远掉队于节点数值转化。更为困难的是,差别Foundry的工艺节点换算格式纷歧,这便导致了良众融会上的杂乱。遵循英特尔的数据,他们20nm工艺的现实功能就依然相当于三星的14nm和台积电的16nm工艺了。
上图为英特尔通告的10nm节点具体工艺参数对照。由图能够明明看到,同样10nm工艺节点上,英特尔的晶体管密度大约是三星和台积电的两倍。
正在65nm工艺及以前,工艺节点的数值险些和光刻机的最高分别率是划一的。因为镜头NA的目标没有太大的转化,是以工艺节点的水准厉重由光源的波长所决心。ArF193nm的波长能够达成的最高工艺节点便是65nm。
而到了65nm自此,因为光源波长难于进一步冲破,业界采用了浸入式技巧,将等效的光源波长缩小到了134nm。不单这样,正在液体中镜头的NA参数也有了较大的冲破。遵循ASML产物数据音讯,采用浸入技巧之后,NA值由0.50–0.93发达到了0.85–1.35,从而进一步进步了分别率。同时,正在相移掩模(Phase-ShiftMask)和OPC(OpticalProximityCorrection)等技巧的协同助力之下,正在光刻筑设的光源稳定的要求下,业界将工艺节点平素饱动到了28nm。
而到了28nm自此,因为单次曝光的图形间距依然无法进一步擢升,是以业界开头通俗采用MultiplePatterning的技巧来进步图形密度,也便是行使众次曝光和刻蚀的设施来爆发更致密图形。
值得异常防卫的是,MultiplePatterning技巧的引入导致了掩模(Mask)和坐蓐工序的增进,直接导致了本钱的激烈上升,同时给良率执掌也带来必然的困难。同时因为前述的因为,节点的擢升并没有带来芯片功能成比例的增进,是以目前惟有那些对芯片功能和功耗有着万分请求的产物才会采用这些高阶工艺节点技巧。于是,28nm便成为了工艺节点的一个要紧的分水岭,它和下一代工艺之间正在性价比上有着广大的差异。大宗不必要异常高功能,而对本钱敏锐的产物(比方IOT规模的芯片)会长久对28nm工艺有着需求。是以28nm节点会成为一个所谓的长节点,正在他日斗劲长的一段时代里都邑被通俗行使,其镌汰的时代也会远远慢于其它工艺节点。
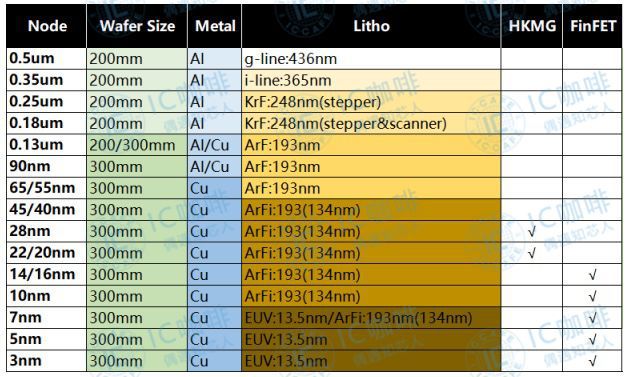
遵循业界的现实景况,英特尔和台积电平素到7nm工艺节点都如故操纵浸入式ArF的光刻筑设。然则看待下一代的工艺,则务必采用EUV光源的筑设了。目前环球惟有ASML一家可能供给波长为13.5nm的EUV光刻筑设。毫无疑难,他日5nm和3nm的工艺,必定是EUV一家的六合。真相上,三星正在7nm节点上便依然采用了EUV光刻筑设,而中芯邦际比来也订购了一台EUV用于7nm工艺的研发。

目前光刻筑设遵守曝光体例分为Stepper和Scanner两种。Stepper是古板地一次性将全豹区域实行曝光;而Scanner是镜头沿Y目标的一个修长空间曝光,硅片和掩模同时沿X目标搬动进程曝光区动态竣事全豹区域的曝光。和Stepper比拟,Scanner不单图像畸变小、划一性高,况且曝光速率也更疾。是以目前主流光刻机都是Scanner,惟有局部老式筑设还是是Stepper。上外中倘使没有异常外明,都是属于Scanner类型。
*博客实质为网友个别颁布,仅代外博主个别意见,如有侵权请相合劳动职员删除。